chamber : wafer를 안에 두고 진공, 열, 가스등 필요한 변수들을 제어할 수 있는 공간
cluster : 일반적인 양산 설비로 chamber들의 복합체 (Integrated Cluster Tool이라고도 부른다.)
아래 그림을 보면 이해하기 쉽겠지만 chamber < process chamber < cluster 의 범위를 갖는다.
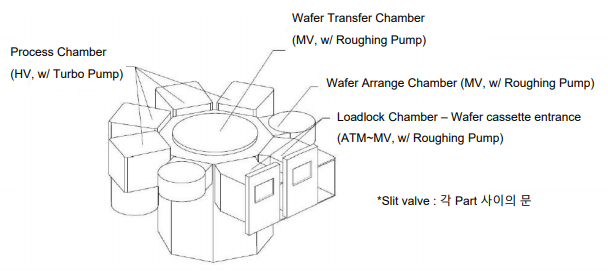
chamber안에서는 진공을 잡는 것이 중요하다. 진공이란 대기압보다 낮은 압력으로 기체가 채워있는 공간으로 pump에 gas 불순물을 제거하고 주입하고 배기하면서 압력을 낮춘다. 그렇다면 왜 진공을 잡는 것이 중요할까?
1. 낮은 분자밀도를 유지하고 불필요한 gas를 배기하기 위함
2. Mean Free path (평균 자유 행로) 확장을 통한 안정적인 plasma 유지하기 위함
3. 화학 물질간의 반응 속도 제어가능한 환경을 만들기 위함 ( 증기압이 낮아지면 반응 속도가 빨라진다.)
뒤에서 박막에 대해서 얘기하겠지만, 이 3가지를 종합해서 박막의 증착 효율을 높일 수 있고 박막과 기판 사이의 접합력 또한 좋아진다.
이를 도와주는 설비가 pump라고 했는데 중요한 3가지 설비만 보고 넘어가자.
Rotary vane pump : 연구실多, 저진공 잡을 때 ( oil이용 )
Dry roots pump : 양산多, 저진공 잡을 때 ( oil을 쓰지 않고 오염, 역류가능성 낮음)
Turbo-molecular pump : 양산多, 고진공 잡을 때( 매우 빨리 돌아가는 선풍기 )

이러한 pump들은 gas의 in - out을 세밀하게 유지, 조정해줄 필요가 있다. 이것을 도와주는 설비는 MFC ( Mass Flow Controller)이고 총량제어가 아닌 in -out을 동일하게 하는 유량제어를 한다. 또한 gas 배기시에 각종 산염기 폐기물의 중화 과정이 필요한데 이것을 도와주는 설비는 Scrubber이다.
'반도체 > 전공정 이론' 카테고리의 다른 글
| [14] 공정 관련 기초 6, 도핑공정 세정공정 (2) | 2020.11.10 |
|---|---|
| [13] 공정 관련 기초 5, 포토공정, Etch공정 (0) | 2020.11.10 |
| [12] 공정 관련 기초 4, Oxidation CVD ALD PVD (0) | 2020.11.09 |
| [11] 공정 관련 기초 3, 진공 플라즈마 (0) | 2020.11.08 |
| [9] 공정 관련 기초 (0) | 2020.11.07 |



